プロダクト
アプリケーション
試料調製から電気的特性評価、物理分析まで
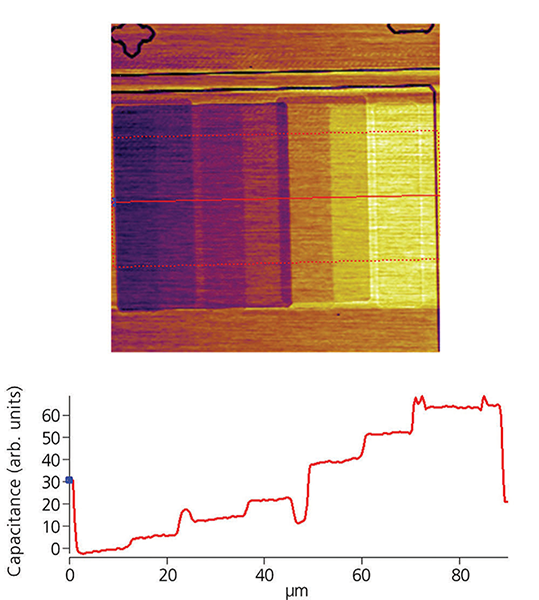
半導体デバイスの性能や潜在的な故障モードを理解するには、ナノスケールの電気的特性評価が重要です。そのための技術として広く使われているのが、原子間力顕微鏡(AFM)です。走査型マイクロ波インピーダンス顕微鏡(sMIM)、ケルビンプローブ力顕微鏡(KPFM)、導電性AFMなど、多数の補完的AFM技術を用いることで、単純なI-V曲線からドーパント濃度マップ(1014 atoms/cm3まで)まで、半導体デバイスシステムの大部分の材料特性を評価することができます。当社のCypherおよびMFP-3D AFMは、これらの技術を組み合わせることができるため、デバイスの性能を完全に把握し最適化することができます。
アプリケーションノート:半導体・マイクロエレクトロニクス研究のためのAFM
アプリケーションノート:走査型マイクロ波インピーダンス顕微鏡 (sMIM)
例えば、デバイスの故障解析では、後で欠陥を分離してさらに特性を調べるために、これらのナノスケールの電気的反応を電子顕微鏡イメージングと関連付けることが必要になることがあります。これを可能にするのが、オムニプローブ・ナノマニピュレーターシリーズであり、電子線誘導電流(EBIC)や電子線吸収電流(EBAC)などの電気的特性のイメージングを10nmレベルの測定対象に接触しながら行えます。
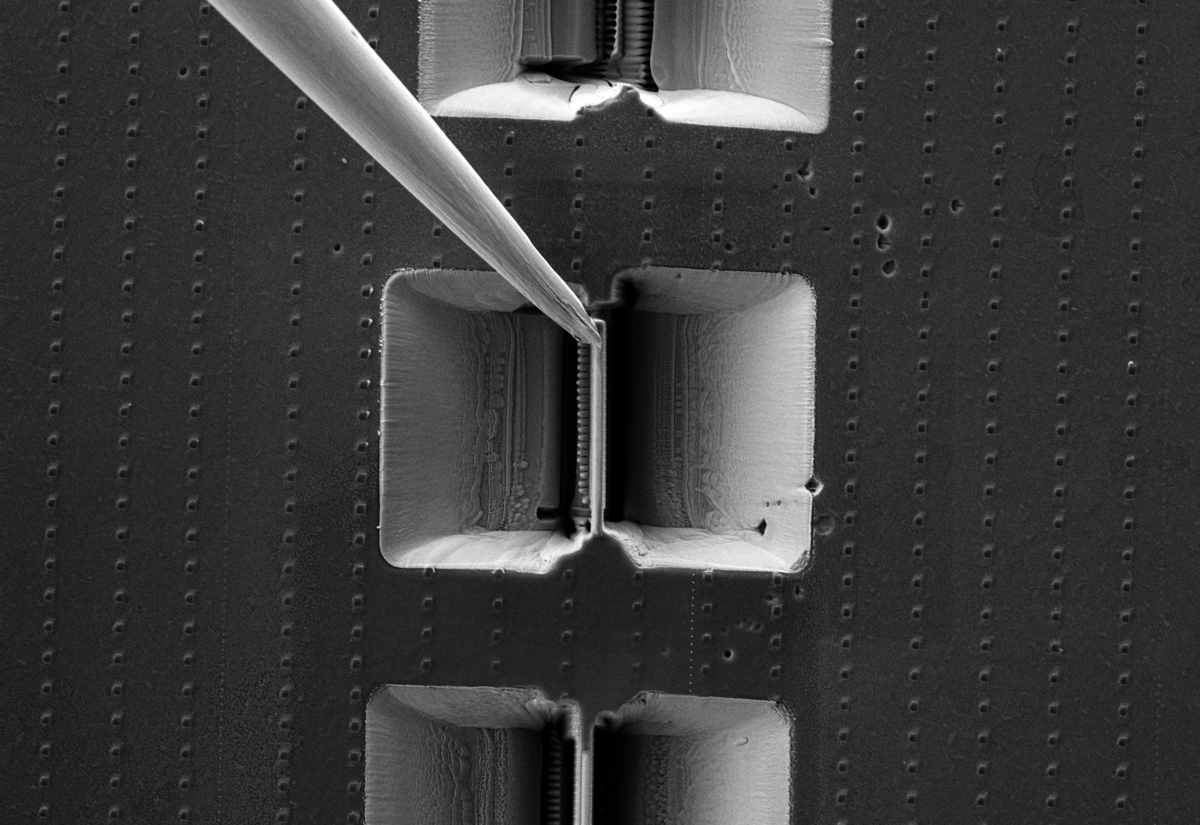
デバイスの故障が見つかり、位置が特定されると、通常はその構造を分離して、別の装置(例:透過型電子顕微鏡)で分析するか、同じ装置(例:集束イオンビーム)でより観測しやすい条件で分析する必要があります。半導体産業では、1つのサンプルを30分以内で処理することが求められます。デバイスが3nmや5nmになると、試料の厚さを20nm以下にする必要があるため、タスクの難易度がさらに高まります。OmniProbe 400はこの点で最適なツールです。ピエゾ式では、10nmスケールで再現性の高い位置決めを確保しながら同心円状の回転が得られるため、高度な試料形状を作成でき、結果として最高品質の試料が得られます。
また、OmniProbe400とAZtec LayerProbeを組み合わせることで、リフトアウトと局所的な膜厚測定を同時に行うことができ、薄い試料を作成するためのプロセス制御が可能です。
アプリケーションノート:LayerProbeとOmniProbe 400を使用した高品質なTEMラメラ作成とオンチップ分析

半導体デバイスの故障解析では、メタル層を露出させる必要がありますが、これは、デバイスのノードサイズが小さく、また構造がより3次元に近づくにつれて困難になります。当社のプラズマアシストエッチツールは、酸化物、窒化物、ポリミドなどの複数の半導体化合物を、メタル層の浮きや損傷を起こさず正確に除去します。当社のフレキシブルなFAツールは、従来のプロセスに比べて最大10倍の速さでダイ・デプロイを可能にし、最高のスループットと生産性を実現します。
デバイスに故障が見つかると、他のダイから分離され、その故障の根本原因を特定するための検出作業が始まります。欠陥の原因は、プロセス上の化学的不一致、異物混入、蒸着材料の結晶構造の変化など、さまざまな可能性があります。これらの潜在的な故障原因の多くは、数ナノメートルという非常に小さな単位です。最新のUltim Extremeエネルギー分散型X線分光器(EDS)は、SEMで撮影するのと同じ条件で作業ができ、バルクデバイスの10nm分解能での元素情報を得ることができます。
TEMでは、AZtecTEMのX-Max TEM検出器を用いて、可能な限り高い分解能で高精度な定量分析を実現できます。
アプリケーションノート:SEMにおける半導体デバイスのマッピング
アプリケーションノート:TEMでの半導体マッピング - ピークオーバーラップをリアルタイムで処理
すべてのデバイスの故障が化学的なものではありません。中には、堆積した材料の構造や位相に起因するものもあります。電子後方散乱回折(EBSD)は、SEM画像の各ピクセルで電子回折パターンを収集し、局所的な結晶構造の特性評価を可能にします。これらの回折パターンを処理することで、結晶粒の構造、相対的な配向、粒界の配向、さらには局所的な応力や歪みを分析することができます。これにより、デバイスの特性と構造との相関が可能となり、特にメタライズドインターコネクトやスルーシリコンビアの導電性の理解に役立ちます。また、EDSと組み合わせることで、構造や元素組成だけでなく、材料の相も知ることができます。Symmetry EDSDは、初のCMOSベースの検出器で、他のEBSDカメラよりも高速かつ高感度です。これにより、より高品質なデータを短時間で収集でき、生産性を最大限に高めることができます。
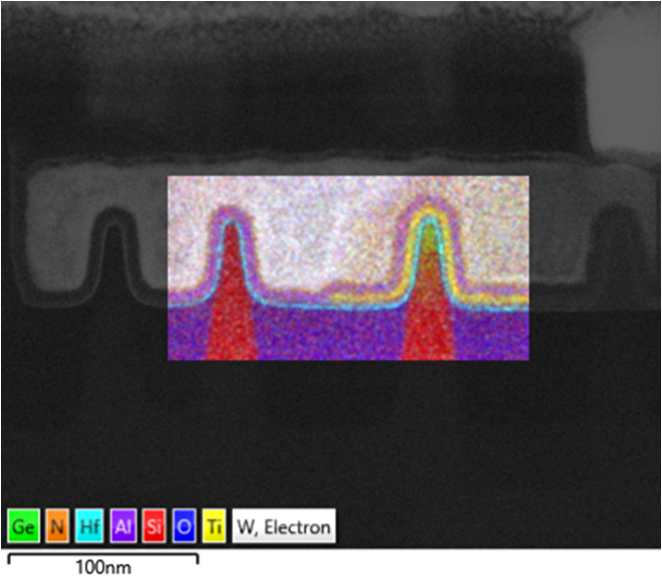


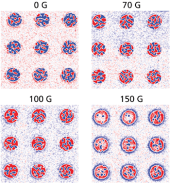
データストレージ業界では、磁気ディスク媒体のナノメートル単位の磁気的挙動を理解することは、最終的なデバイス性能を理解する上で非常に重要です。 磁気力顕微鏡(MFM)は、ディスクメディアやその他の磁気デバイスの磁区構造を直接イメージングできます。磁気記録されたビット分析や、それを読み書きするトランスデューサ性能分析において、可変磁場モジュール(VFM)を搭載したMFP-3D Infinity AFMは、最も困難な試料を正確に分析できます。
また、MFMは、圧電力顕微鏡(PFM)と一緒に使用することで、マルチフェロイック複合材料の磁電結合の特性を評価することができます。これらの材料は、電界と磁界の両方を調整可能な信号処理デバイスに使用できることから、重要な研究対象となっています。